
在消费电子领域正迎来技术融合与体验升级的新浪潮,AI终端的爆发增长,AIPC以及AI手机实现本地高效算力支持,智能眼镜实时翻译,AR导航等实用功能的崛起。
从市场趋势看,AI 手机的普及进一步放大了散热需求。IDC 预测,2025 年全球搭载生成式 AI 功能的智能手机出货量将达 3.7 亿部,占整体市场份额 30%;OCID 数据显示,2027 年中国人工智能手机销量预计突破 1.86 亿台。庞大的出货量背后,散热技术已成为厂商实现产品差异化的关键指标,同时需平衡消费者对设备轻薄化的需求。
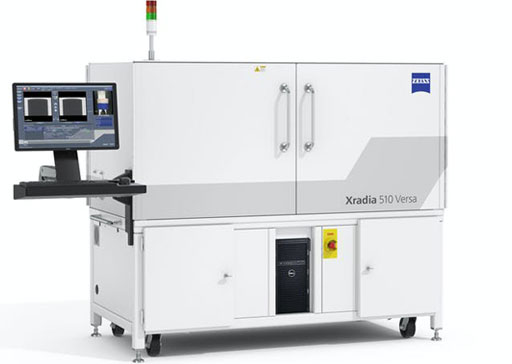
VC 均热板轻薄化的技术挑战
当前手机厂商对机身厚度的追求(部分机型已低于 7.5mm),要求 VC 均热板厚度进一步压缩至 0.3mm 以下,由此带来两大核心技术难题:
01 密封与流道设计矛盾
腔体厚度减小导致内部流道截面积不足(需≥0.1mm 才能保证水蒸气顺畅流动),同时密封工艺难度显著提升 —— 采用激光焊接时,焊缝宽度需控制在 0.2mm 以内,且需避免焊接应力导致腔体变形,否则会破坏真空环境,导致散热失效;
02 相变传热性能衰减
当腔体厚度低于 0.4mm 时,毛细芯的有效厚度不足(需≥0.15mm 才能保证足够的毛细力),导致液态水回流速度下降,同时水蒸气扩散路径缩短,易出现 “汽液混合” 现象,使等效导热系数骤。
目前行业内正通过两种技术路径突破瓶颈:一是采用新型毛细芯材料(如纳米多孔铜,孔隙率提升至 70%),增强毛细力以提升回流效率;二是优化腔体结构(如采用阶梯式流道,局部增厚至 0.5mm),在保证整体轻薄的同时预留足够流道空间。未来随着这些技术的成熟,VC 均热板将更好地适配AI手机的散热需求。

质量挑战:
作为VC均热板的核心内部结构,铜柱与毛细结构的尺寸设计是在多重矛盾中寻求平衡的艺术。铜柱首要保证结构强度,但其尺寸过大会严重阻碍蒸汽扩散与冷凝液回流,增加流阻,因此现代设计趋向于采用阵列式微铜柱,在确保抗塌陷能力的同时最小化对相变流传热的干扰。毛细结构是液体回流的驱动力,其尺寸直接影响性能极限:厚度与孔径过小虽能产生强毛细力,但会导致液体流动阻力激增且热阻变大;厚度与孔径过大则会使毛细力不足,极易引发蒸发端干涸。更优设计在于为毛细结构选择更佳厚度与孔径范围,以更大化其综合性能系数(即平衡毛细力与渗透率)。

在设计和生产制造过程中需要关注铜柱的直径与高度,毛细结构的厚度与孔径,凹陷/鼓包等缺陷检查以确保VC均热板的质量。
观察VC均热板样品:
1 铜网缺陷
1.1 边缘
8μm体素分辨率对ROI扫描成像,可观察到裙边、焊道、铜柱和铜网结构,注意到铜网有一处凹陷。
测量裙边和铜柱等各层结构的厚度
ZEISS的3D软件所示重构后的2D切片,XY方向
ZEISS的3D软件所示重构后的2D切片,YZ方向
体素:8μm
边缘:测量铜柱直径
并对凹陷处铜网进一步放大扫描
ZEISS的3D软件所示重构后的2D切片,XZ方向
ZEISS的3D软件所示重构后的3D结构
体素:8μm
1.2 铜网缺陷
1.5μm体素分辨率对凹陷处铜网扫描成像,可观察到铜柱和铜网变形、粘连。
ZEISS的3D软件所示重构后的2D切片。
每个象限代表一个不同的正交虚拟切片,彩色线对应相同的边框颜色切片。比如,上排象限内的绿色线位置对应左下象限的绿色边框内的2D切片。
通过移动彩色线可以观察对应颜色线框内的虚拟切片变化。
ZEISS的3D软件所示重构后的2D切片,XY方向
测量变形铜柱和未变形铜柱的厚度;测量铜柱内孔隙大小和铜网编织结构的宽度
ZEISS的3D软件所示重构后的2D切片,YZ方向
体素:1.5μm
ZEISS Xradia Versa 蔡司X射线显微镜采用无损三维成像技术,为VC均热板的内部结构表征与缺陷分析提供了完整解决方案。该系统凭借其卓越的多尺度成像能力,可在低倍模式下快速定位内部整体结构,并无缝切换至高倍模式,对毛细结构、铜柱及凹陷等微观特征进行高分辨率三维解析。结合专用的三维可视化与分析软件,用户可对样品进行任意角度的虚拟剖切与立体渲染,生成高质量的三维彩色模型,从而揭示内部结构的空间关系与缺陷分布,为产品工艺优化与可靠性评估提供关键的洞见和数据支撑。
蔡司拥有丰富的产品线包含显微镜,蓝光扫描仪,蔡司三坐标,茂名工业CT,助力全面解决电子客户面临质量挑战与痛点。











